QRコード

お問い合わせ


ファックス
+86-579-87223657


住所
中国浙江省金華市武夷県紫陽街Wangda Road
半導体とFPDパネルディスプレイでは、薄膜の準備が重要なプロセスです。 薄膜(TF、薄膜)を準備するには多くの方法がありますが、次の2つの方法が一般的です。
● CVD(化学蒸気堆積)
● PVD (物理蒸着)
このうち、バッファ層/活性層/絶縁層はすべて、PECVD を使用して装置のチャンバー内で堆積されます。
● SiN および Si/SiO2 膜の堆積には、特殊ガス: SiH4/NH3/N2O を使用します。
●一部のCVDマシンは、キャリアの移動度を高めるために水素化にH2を使用する必要があります。
●NF3はクリーニングガスです。比較すると、F2 は毒性が高く、SF6 の温室効果は NF3 よりも高くなります。
半導体デバイスプロセスでは薄膜の種類が増えており、一般的なSiO2/Si/SiNに加え、W、Ti/TiN、HfO2、SiCなどもあります。
これは、さまざまな種類の薄膜を製造するために、半導体産業で使用される先端材料の前駆体が数多く存在する理由でもあります。
1。CVDの種類といくつかの前駆ガス
2. CVDの基本メカニズムと膜質
CVD は非常に一般的な概念であり、多くの種類に分類できます。。 一般的なものは次のとおりです。
● pecvd:プラズマ強化CVD
●LPCVD:低圧CVD
●ALD:原子層の堆積
● MOCVD:金属有機CVD
CVD プロセス中、化学反応の前に前駆体の化学結合を切断する必要があります。
化学結合を破壊するためのエネルギーは熱から生まれるため、チャンバーの温度は比較的高くなります。これは、パネルの基板ガラスやフレキシブルスクリーンのPI材料など、一部のプロセスには友好的ではありません。したがって、他のエネルギー(プラズマなどを形成するなど)を入力して、温度を必要とするプロセスを満たすためにプロセス温度を下げることにより、熱予算も削減されます。
したがって、A-SI:H/SIN/POLY-SIのPECVD堆積は、FPDディスプレイ業界で広く使用されています。一般的なCVD前駆体とフィルム:
多結晶シリコン/単結晶シリコン SiO2 SiN/SiON W/Ti WSi2 HfO2/SiC
CVDの基本メカニズムのステップ:
1. 反応前駆体ガスがチャンバーに入る
2。ガス反応によって生成される中間製品
3.ガスの中間生成物は、基質表面に拡散します
4. 基板表面に吸着・拡散
5。化学反応は、基質表面、核形成/島の形成/フィルム形成で発生します
6.副産物は脱着し、真空が汲み上げられ、治療のためにスクラバーに入った後に排出されます
前述のように、プロセス全体には、拡散/吸着/反応などの複数のステップが含まれています。フィルム全体の形成率は、温度/圧力/反応ガス/種類の基質の種類など、多くの要因の影響を受けます。 拡散には予測のための拡散モデルがあり、吸着には吸着理論があり、化学反応には反応速度論的理論があります。
プロセス全体で、最も遅いステップが反応速度全体を決定します。これは、プロジェクト管理の重要なパス方法に非常に似ています。最長のアクティビティフローにより、プロジェクト期間が最も短くなります。このパスの時間を短縮するためにリソースを割り当てることにより、期間を短縮できます。 同様に、CVD もプロセス全体を理解することで成膜速度を制限する重要なボトルネックを見つけ、パラメータ設定を調整して理想的な成膜速度を達成できます。
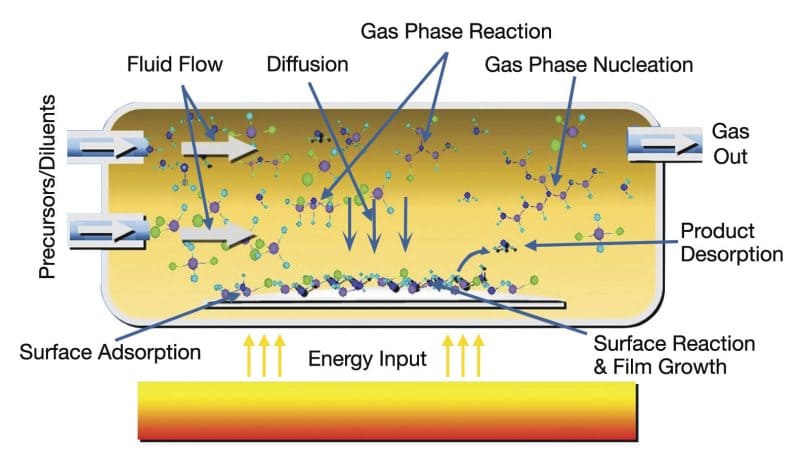
フィルムには、平坦なもの、穴を埋めるもの、溝を埋めるものなどがあり、機能が大きく異なります。 商用 CVD マシンは、次の基本要件を満たしている必要があります。
●機械処理能力、堆積速度
●一貫性
●気相反応は粒子を生成できません。気相で粒子を生成しないことが非常に重要です。
他のいくつかの評価要件は次のとおりです。
● 優れた段差被覆性
●アスペクト比のギャップを埋める能力(コンフォーマリティ)
●膜厚均一性が良好です。
●高純度・高密度
● 低い膜応力による高い構造完成度
●良好な電気特性
●基材との密着性に優れています。



+86-579-87223657


中国浙江省金華市武夷県紫陽街Wangda Road
Copyright © 2024 WuYi TianYao Advanced Materials Tech.Co.,Ltd.無断転載を禁じます。
Links | Sitemap | RSS | XML | プライバシーポリシー |
