QRコード

お問い合わせ


ファックス
+86-579-87223657


住所
中国浙江省金華市武夷県紫陽街Wangda Road
シリコン炭化物基板には多くの欠陥があり、直接処理することはできません。特定の単結晶薄膜は、チップウェーハを作るためにエピタキシャルプロセスを通じてそれらに栽培する必要があります。この薄膜はエピタキシャル層です。ほとんどすべての炭化物装置は、エピタキシャル材料で実現されています。高品質の炭化シリコン均一なエピタキシャル材料は、炭化シリコンデバイスの開発の基礎です。エピタキシャル材料の性能により、炭化シリコンデバイスのパフォーマンスの実現が直接決定されます。
高電流と高度の高度の炭化シリコンデバイスは、エピタキシャル材料の表面の形態、欠陥密度、ドーピング、厚さの均一性により、より厳しい要件を提案しています。大規模、低い欠陥のある密度と高ユニフォーム性炭化シリコンエピタキシーシリコンカーバイド産業の発展の鍵となっています。
高品質の準備炭化シリコンエピタキシー高度なプロセスと機器が必要です。最も広く使用されている炭化シリコンエピタキシャル成長法は、化学蒸気堆積(CVD)です。これは、エピタキシャルフィルムの厚さとドーピング濃度の正確な制御、欠陥が少なく、中程度の成長率、自動プロセス制御の利点があります。これは、成功裏に商業化された信頼できるテクノロジーです。
炭化シリコンCVDエピタキシーは、一般に高温壁または温かい壁CVD機器を使用しており、これにより、より高い成長温度条件(1500-1700)の下でのエピタキシャル層4H結晶SICの継続を保証します。長年の開発の後、熱い壁または暖かい壁CVDは、入口ガスの流れと基質表面の関係に応じて、水平水平構造反応器と垂直垂直構造反応器に分割できます。
炭化シリコンエピタキシャル炉の品質には、主に3つの指標があります。 1つ目は、厚さの均一性、ドーピングの均一性、欠陥率、成長率など、エピタキシャル成長性能です。 2つ目は、加熱/冷却速度、最高温度、温度の均一性など、機器自体の温度性能です。そして最後に、単価と生産能力を含む、機器自体のコストパフォーマンス。
ホットウォールの水平CVD、暖かい壁惑星CVD、準ホット壁の垂直CVDは、この段階で商業的に適用された主流のエピタキシャル機器技術ソリューションです。 3つの技術機器には独自の特性もあり、ニーズに応じて選択できます。構造図を下の図に示します。

熱い壁の水平CVDシステムは、一般に、空気の浮選と回転によって駆動される単一の大規模成長システムです。優れた侵入インジケーターを実現するのは簡単です。代表モデルは、イタリアのLPE CompanyのPE1O6です。このマシンは、900個のウェーハの自動荷重と荷重を実現できます。主な特徴は、高成長率、短いエピタキシャルサイクル、ウェーハ内および炉間の良好な一貫性などです。中国で最も高い市場シェアを持っています。

LPEの公式レポートによると、主要なユーザーの使用と組み合わされて、PE1O6エピタキシャル炉によって生成された厚さ30μm未満の100-150mm(4-6インチ)4H-SICエピタキシャルウェーハ製品は、次の指標を安定に実現できます。密度≤1cm-2、表面欠陥のない領域(2mm×2mm単位セル)≥90%。
JSG、CETC 48、Naura、Nasoなどの国内企業は、同様の機能を備えたモノリシックな炭化シリコンエピタキシャル装置を開発し、大規模な出荷を達成しています。たとえば、2023年2月、JSGは6インチのダブルワーファーSICエピタキシャル装置をリリースしました。機器は、反応チャンバーのグラファイト部分の上層と下層の上層と下層を使用して、単一の炉で2つのエピタキシャルウェーハを栽培し、上下のプロセスガスを個別に調整し、温度差は5°C以下であり、これにより、モノリスティック剤の生産能力のある生産能力のある生産容量の不利な能力を効果的に増やすことができます。SICコーティングハーフムーン部品。私たちは、ユーザーに6インチと8インチのハーフムーン部品を供給しています。

層の惑星配置を備えた暖かい壁の惑星CVDシステムは、単一の炉での複数のウェーハの成長と高出力効率によって特徴付けられます。代表的なモデルは、ドイツのAIXTRONのAIXG5WWC(8x150mm)およびG10-SIC(9×150mmまたは6×200mm)シリーズのエピタキシャル装置です。
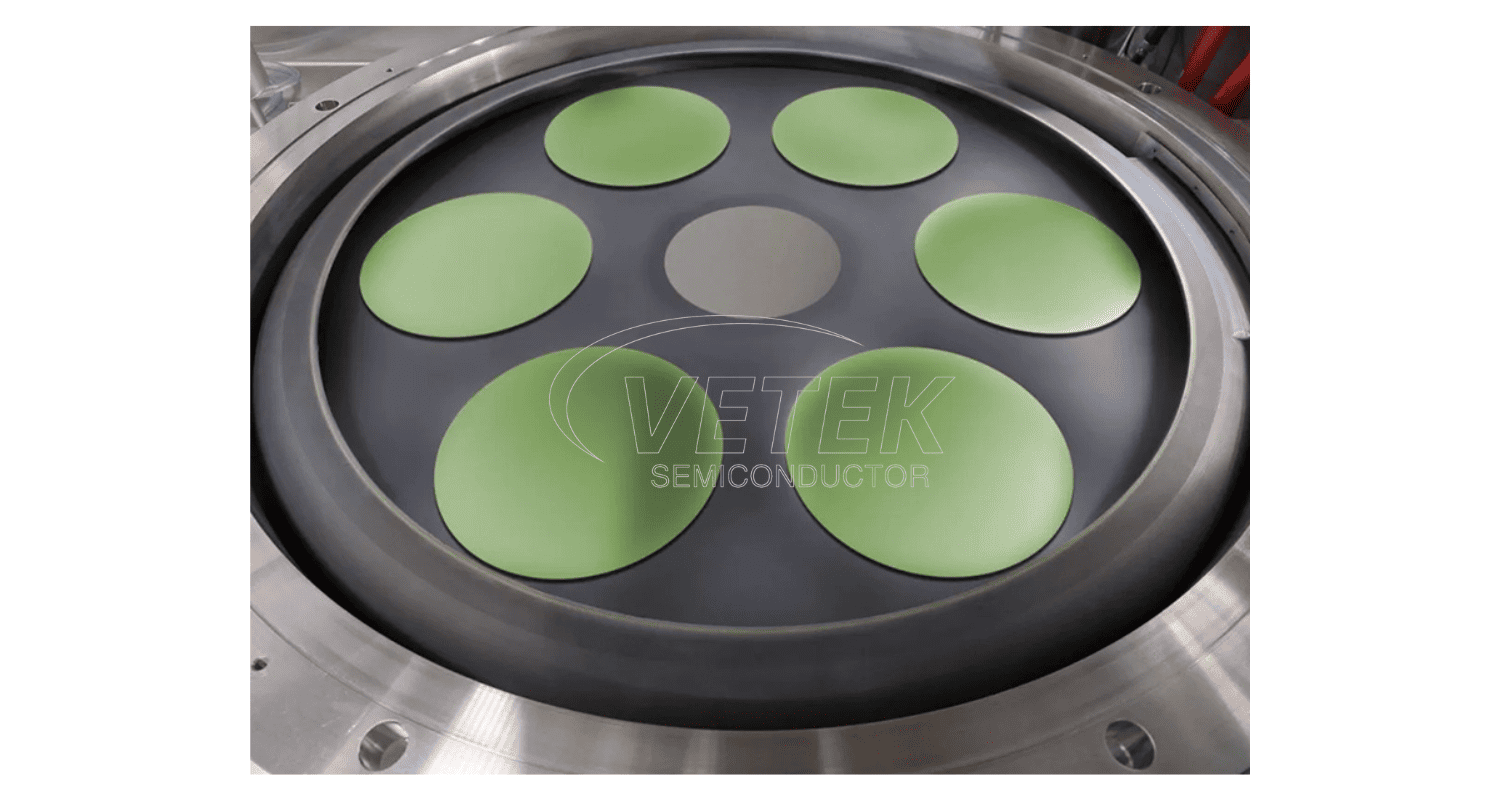
Aixtronの公式報告によると、G10エピタキシャル炉によって生成された10μmの厚さの6インチ4H-SICエピタキシャルウェーハ製品は、次の指標を安定に実現できます。濃度の不均一性<2%。
これまで、このタイプのモデルは国内ユーザーが使用することはめったになく、バッチ制作データは不十分であり、ある程度そのエンジニアリングアプリケーションを制限しています。さらに、温度フィールドとフローフィールド制御の観点からマルチワーファーエピタキシャル炉の技術的障壁が高いため、同様の国内機器の開発はまだ研究開発段階にあり、その間には、6インチや8インチのTACコーティングまたはSICコーティングで8インチなどのAixtron惑星容疑者を提供できます。
準ホット壁の垂直CVDシステムは、主に外部の機械的支援を通じて高速で回転します。その特徴は、粘性層の厚さがより低い反応チャンバー圧によって効果的に減少し、それによってエピタキシャル成長速度を増加させることです。同時に、その反応チャンバーには、SIC粒子を堆積させることができる上壁がなく、落下する物体を生成するのは容易ではありません。欠陥制御には固有の利点があります。代表的なモデルは、日本のヌフレアの単一ワーファーのエピタキシャル炉とepirevos8です。
Nuflareによると、Epirevos6デバイスの成長率は50μm/h以上に達する可能性があり、エピタキシャルウェーハの表面欠陥密度は0.1cm-²未満を制御できます。均一性制御の観点から、NuflareエンジニアのYoshiaki Daigoは、Epirevos6を使用して成長した10μmの厚さ6インチのエピタキシャルウエハーの溶解性均一性の結果を報告しました。上部グラファイトシリンダー.
現在、Core Third Third GenerationやJSGなどの国内の機器メーカーは、同様の機能を備えたエピタキシャル機器を設計および発売しましたが、大規模には使用されていません。
一般に、3種類の機器には独自の特性があり、さまざまなアプリケーションのニーズで特定の市場シェアを占有します。
熱い壁の水平CVD構造は、超高速成長率、品質と均一性、シンプルな機器の操作とメンテナンス、成熟した大規模生産アプリケーションを特徴としています。ただし、シングルワーファーの種類と頻繁なメンテナンスにより、生産効率は低くなっています。温かい壁の惑星CVDは一般に6(ピース)×100 mm(4インチ)または8(ピース)×150 mm(6インチ)トレイ構造を採用しています。準ホット壁の垂直CVDには複雑な構造があり、エピタキシャルウェーハ生産の品質欠陥制御は優れており、非常に豊富な機器のメンテナンスと使用経験が必要です。
速い成長率
単純 機器構造と
便利なメンテナンス
大きな生産能力
高い生産効率
優れた製品欠陥制御
長い反応室
メンテナンスサイクル
複雑な構造
制御が難しい
製品の一貫性
複雑な機器構造、
困難なメンテナンス
代表
装置
メーカー
ホットウォール水平CVD
温かい壁惑星CWD
準ホット壁垂直CTD
利点
短所
短いメンテナンスサイクル
イタリアLPE、日本tel
ドイツのアイクストロン
Japan Nuflare
業界の継続的な開発により、これら3種類の機器が構造の観点から繰り返し最適化およびアップグレードされ、機器の構成がますます完璧になり、異なる厚さと欠陥要件を持つエピタキシャルウェーハの仕様と一致する上で重要な役割を果たします。



+86-579-87223657


中国浙江省金華市武夷県紫陽街Wangda Road
Copyright © 2024 WuYi TianYao Advanced Materials Tech.Co.,Ltd.無断転載を禁じます。
Links | Sitemap | RSS | XML | プライバシーポリシー |
